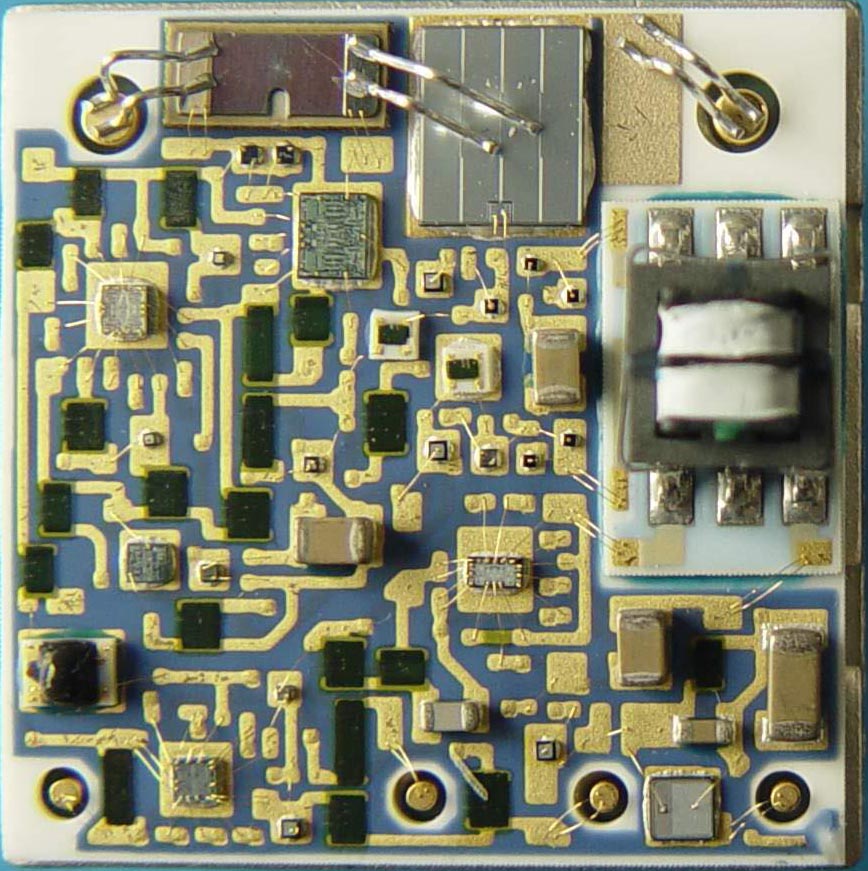
产品详情
多芯片组件(MCM)是指多个集成电路芯片电连接于共用电路基板上,并利用它实现芯片间互连的组件。它是一种典型的高级混合集成组件。这些元件通常通过引线键合、载带键合或倒装芯片的方式未密封地组装在多层互连的基板上,然后经过塑料模塑,再用与安装QFP或BGA封装元件同样的方法将它安装在印制电路板上。
比起将元件直接安装在PCB上,MCM具有一定的优势。
(1)性能高,例如芯片间传输路径缩短(减少了信号延迟)、低电源自感、低电容、低串扰以及低驱动电压。
(2)小型化,由于MCM的小型化和多功能的优点,系统电路板的I/O数得以减少。
(3)广泛应用于专用集成电路,尤其是生产周期短的产品。
(4)主要使用廉价的硅芯片,允许混合的半导体技术,例如si、Ge或GaAs。
(5)混合型结构,包括以芯片级或球栅阵列封装的形式进行表面安装的设备以及离散片式的电容器和电阻。
(6)由于封装体内芯片有限,可保证所封装产品有较高的成品率。
(7)通过缩短元件和芯片间的互连尺寸,提高了产品可靠性。
(8)对各种两级互连有良好的适应性。引线框架方案可以提高连接点的性能,并使升级模块化。
(9)增加了许多新功能。
虽然使用MCM有很多优势,但它仍然存在不足之处。阻碍其普遍应用的主要问题是元件如何保持各自的成品率。虽然它的行情看涨,但要提高大部分元件的成品率仍是任重而道远。另一个关键是成本,最新的MCM—L(叠层基片多芯片组件)技术有较低的制造成本。
下面是与MCM制造有关的三项技术:(1)基板技术。(2)芯片安装及焊接技术,例如引线键合、载带自动焊和倒装芯片法。(3)封装技术。 MCM分类 MCM原则上要具备下列条件:基板具有多层导体层;封装效率>20%;封装外壳的I/O引线>100;有多个专用集成电路(ASIC,application specific integrated circuit)或者超大规模集成电路(VLSI,Very Large Scale Integration)等。MCM可以分为四大类。1)MCM—Z(Z意为零——Zero):组件不使用基板,而是芯片到芯片、芯片到封装的直接互连。2)MCM—L(L意为层压板——Laminate):组件基板采用细导线印制电路板技术,在塑料层压介电板上涂覆铜导线。3)MCM-C(C意为陶瓷——CerarIlic):组件的基板为共烧陶瓷,并用厚膜(丝网印制)技术制作导体图样(“共烧”意思是导线和陶瓷同时在一个炉子中加热制作)。4)MCM—D(D意为沉积——Deposited):是指通过在介电材料(有机或者无机)上进行薄膜沉积金属来完成互连。陶瓷、玻璃、硅或金属等都可用于基板。有时把硅基板的MCM—D称为MCM—Si。后三类MCM还派生出MCM—D/L、MCM—D/C、MCM-D/Si、MCM—Si等封装结构。
MCM的特点是:封装延迟时间缩小,易于实现组件高速化;缩小整机/组件封装尺寸和重量,一般体积可减小1/4,重量减轻1/3;可靠性大大提高。
(1)高速度(高频):20世纪80年代末微处理器(MPU)的工作频率为10~20MHz;90年代为100~200MHz,目前超大型计算机的工作频率达到几个GHz。
影响MPU存储器高速化的主要障碍是信号传输延迟问题,MCM产品采用多个裸芯片高密度地安装在一起,缩短了传输路径长度,使得信号延迟大大减小,从而提高了工作频率。
(2)高密度:目前MCM电路图形可实现导体线宽/间距为100~20μm;埋孔直径为150~50μm;通孔直径为300~200μm;焊盘直径为250~150μm;层间厚度为100~30μm的水平。SMT的安装效率(LSI总面积/组件基板面积)为5%~15%,COB约为30%,MCM—L在30%~40%,MCM—C在30%~50%,MCM—D可达到70%以上。
(3)高散热:随着高密度、高速度的发展,产生MCM的散热问题。目前出现了一些新的散热技术,使得散热效率大大提高。
(4)低成本:MCM技术比一般的SMT等技术成本降低2~4倍,而MCM—L在低成本开发方面最有前景。



